TSMC, AI칩 수요 견조 재확인…삼성·SK, HBM 사업 성장세 '쾌청'
 Master
0
2
0
0
04.21 13:41
Master
0
2
0
0
04.21 13:41
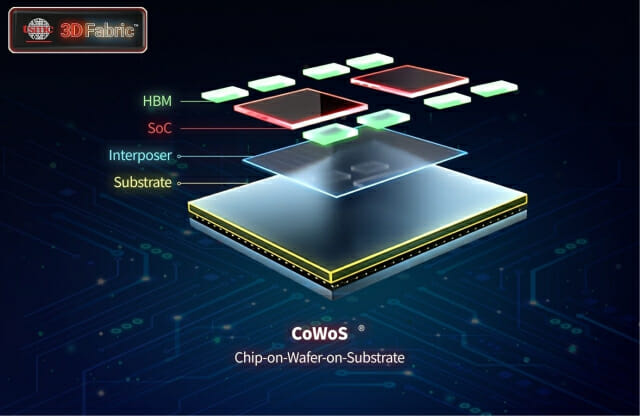
대만 파운드리 업체 TSMC가 최근 높아진 거시경제 불확실성 속에서도 당초 계획한 첨단 패키징 투자를 유지했다. AI 반도체 수요가 중장기적으로 견조할 것이라는 전망에 따른 전략이다. 주요 메모리 기업들의 HBM(고대역폭메모리) 사업도 공급 과잉 우려를 덜었다는 평가와 전망이 제기된다.
21일 업계에 따르면 글로벌 빅테크의 지속적인 AI 가속기 투자에 따라 올해 삼성전자, SK하이닉스 등의 HBM 수요도 견조할 것으로 관측된다.
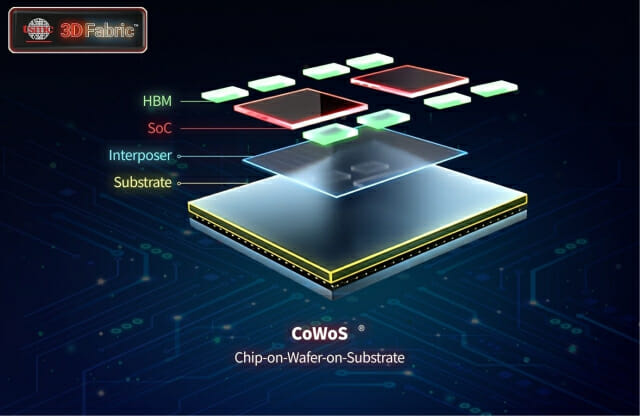
앞서 TSMC는 지난 17일 1분기 실적발표 컨퍼런스콜에서 올해 설비투자(CapEx) 규모를 380억~420억 달러를 제시했다. 최근 중국 딥시크와 같은 저비용·고효율 AI 모델의 등장, 미국의 관세 압박 등으로 AI 인프라 투자에 대한 불확실성이 높아졌으나, 지난해 발표한 계획을 그대로 유지했다.
TSMC는 "이전보다는 상황이 개선됐으나, AI 수요가 여전히 공급을 초과하는 상황으로 많은 설비능력 확장이 필요하다"며 "관제 및 지정학적 이슈에 대해 고객사의 행동 변화가 관찰되지 않아 기존 수요를 유지한다"고 설명했다.
TSMC가 전망하는 2024~2029년 AI 가속기 관련 매출의 연평균 성장률은 45%에 달한다. 올해 매출액도 전년 대비 2배 성장할 전망이다.
이에 TSMC는 'CoWoS' 생산능력을 2배(월 7만장)로 확장할 계획이다. CoWoS는 TSMC가 자체 개발한 2.5D 패키징으로, 칩과 기판 사이에 인터포저라는 얇은 막을 삽입해 반도체 성능을 높이는 기술이다. 특히 고성능 시스템반도체와 HBM 등을 함께 집적하는 AI 가속기의 필수 요소로 각광받고 있다.
최첨단 패키징 투자 확대는 HBM을 공급하는 메모리 업계에도 수혜로 작용한다. 특히 SK하이닉스는 AI 산업을 주도하는 엔비디아는 물론, 구글·AWS(아마존웹서비스) 등 CSP(클라우드서비스제공자) 기업들의 ASIC(주문형반도체)에 최신형 HBM을 공급하고 있다.
일례로 엔비디아는 올 1분기 '블랙웰' 시리즈의 최신 칩인 'GB200'를 출시했다. 구글의 경우 올해 7세대 TPU(텐서처리장치)인 '아이언우드'를 올 하반기 출시할 예정이다. 두 제품 모두 HBM3E(5세대 HBM)이 탑재된다. 나아가 엔비디아는 올해 하반기 HBM4를 탑재한 '루빈' 칩을 출시한다.
SK하이닉스도 이에 맞춰 올 상반기 고부가 HBM 생산 비중을 확대하고 있다. 올 상반기 전체 HBM3E의 출하량에서 12단 제품의 비중을 절반 이상으로 확대하는 것이 목표다. 실제로 SK하이닉스 내부에서는 최선단 제품의 생산능력을 확대하기 위한 준비에 적극 나서고 있는 것으로 알려졌다.
김운호 IBK투자증권 연구원은 "SK하이닉스의 HBM 입지는 올해에도 유지될 것으로 예상되며, 생산 능력도 글로벌 최대 규모 수준일 것"이라며 "올 하반기는 HBM3E 12단이 주력 제품이 될 것으로 기대된다"고 밝혔다.
한편 삼성전자·마이크론도 HBM 사업 확대에 매진하고 있다. 삼성전자는 HBM3E 개선품을 개발해 엔비디아와 재공급을 위한 퀄(품질) 테스트를 거치고 있다. 올 2분기 중 결과가 나올 전망이다. 마이크론 역시 HBM3E 12단까지 개발을 완료해, 엔비디아향 공급을 추진 중이다.

















